고급 패키징 기술의 발전과 반도체 시장 변화
전자 기기의 소형화와 성능 향상을 촉진하는 중요한 동력으로 고급 패키징 기술이 주목받고 있습니다. 성능(Performance), 전력(Power), 면적-비용(Area-Cost), 출시 시간(Time-to-Market)이라는 PPACt들이 현대 패키징 기술의 핵심 초점이 되면서, 특히 3D 집적회로(3DIC) 기술에 대한 관심이 크게 증가하고 있습니다. ‘3D’라는 용어는 이제 전통적인 백엔드 패키지 공정을 넘어, 칩 내부에서의 이종 집적화까지 포괄하는 개념으로 확장되었습니다.
1. 전통적인 패키지 연결 기술
패키지 내부 연결을 위한 다양한 방법론이 존재합니다. 대표적인 전통 방식으로는 무연 납 솔더 캡과 구리 필러를 사용하는 구리 마이크로 범프가 있습니다. 이 방식은 중고급 플립칩 패키지에서 널리 채택되며, 인텔의 Ponte Vecchio 아키텍처는 3D 적층 칩셋 시스템을 마이크로 범프를 통해 조립하는 대표적인 사례입니다. 이러한 마이크로 범프는 약 30-40μm의 피치를 가지며, 실리콘 칩과 칩 간의 연결을 위해 더욱 세밀한 피치로 축소될 수 있습니다.
2. 하이브리드 본딩 연결 기술의 등장
최근 패키지 기술은 점점 더 정밀한 피치와 저지연 특성을 요구하게 되었습니다. 이러한 요구에 부응하기 위해 하이브리드 본딩 연결 기술이 개발되었습니다. 하이브리드 본딩은 금속-금속과 절연체-절연체의 접합면을 모두 포함하는 ‘하이브리드’ 구조로, 기존 마이크로 범프보다 연결 패드 피치를 줄이고 데이터 처리량을 증가시키는 데 기여합니다. 이 방식은 다양한 기능을 가진 칩렛(chiplet)을 조립하는 데 사용되며, 각 칩렛은 고유한 기능을 수행하는 소형 집적회로(IC)로 구성됩니다.
3. 칩렛 (chiplet) 기반 패키징의 잠재력
하이브리드 본딩은 칩 간 데이터 전송량을 증가시키고 전반적인 성능을 향상시킬 수 있는 잠재력을 지니고 있습니다. 칩렛 기반 패키징은 시스템 온 칩(SoC)을 기능적으로 분할하는 개념에 기반하며, 분할된 실리콘 칩은 서로 다른 I/O 프로토콜을 갖추고 프런트엔드 패키징 프로세스를 통해 연결됩니다. 2.5D 및 3D 통합을 통해 고성능 컴퓨팅 시스템이 더욱 정교한 패키지 구조로 발전할 수 있으며, 이는 차세대 반도체 시장의 중요한 흐름을 주도할 것입니다.
고급 패키징 기술은 반도체 산업에서 중요한 역할을 하며, 신기술 도입 및 개선을 통해 더 작고 강력한 전자 기기 개발이 가능해지고 있습니다.
고급 반도체 패키징 기술의 프론트엔드 및 백엔드 3D 플랫폼 개요
현대 반도체 기술에서 다수의 개별 기능을 수행하는 칩을 개별 소스 웨이퍼에서 제조한 후 적절한 패키징 기술을 통해 통합하는 방식은 매우 중요한 역할을 합니다. TSMC가 제시한 바와 같이, 이러한 기술들은 백엔드 3D 플랫폼과 프론트엔드 3D 플랫폼으로 분류할 수 있습니다.
프론트엔드 3D 플랫폼
프론트엔드 3D 기술은 칩을 쌓아 올리는 실리콘 프로세스에 중점을 둡니다. 주요 기술로는 칩 온 웨이퍼(CoW), 웨이퍼 온 웨이퍼(WoW), 하이브리드 본딩 연결 등을 활용한 방법이 있습니다. 이러한 기술은 칩 사이의 데이터 전송 대역폭, 전력 전달, 기계적 안정성 및 열 관리와 같은 다양한 요소를 고려하여 설계됩니다. 일반적으로 칩 스택킹을 위해서는 접촉 패드 피치를 10μm 이하로 축소하는 것이 중요하며, 일부 기술은 1μm 이하로도 축소 가능합니다. 이러한 스케일링은 하이브리드 본딩 기술과 밀접한 관련이 있으며, 실리콘 관통 비아(TSV), 산화물 관통 비아(TOV), 다이 간 간극 채움(IDGF) 등의 구조와 결합하여 동일하거나 상이한 크기의 칩들을 수직으로 적층하는 데 기여합니다.
백엔드 3D 플랫폼
백엔드 3D 플랫폼은 실리콘과 패키징 요소(예: 인터포저 또는 기판) 간의 연결, 또는 패키지 모듈(예: 팬아웃 모듈) 간의 연결에 중점을 둡니다. 여기에는 실리콘 인터포저(2.5D)와 팬아웃(Fanout)과 같은 기술들이 포함됩니다. 이 플랫폼은 보다 성숙한 연결 기술을 통해 대규모 집적화를 지원하며, 칩렛 통합 시 시스템 레벨에서의 성능을 최적화하는 데 기여합니다.
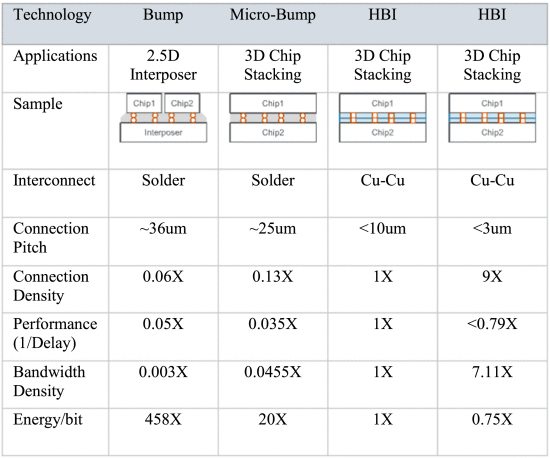
이와 같은 고급 패키징 기술들은 반도체 칩의 소형화 및 성능 향상을 더욱 가속화하며, 차세대 전자 제품의 핵심 기반을 제공합니다. 프론트엔드와 백엔드 기술의 협력은 PPACt에서 우위를 확보하는 데 중요합니다.
참고문헌
'반도체' 카테고리의 다른 글
| 엔비디아 GPU의 세대별 비교 (1) | 2024.11.17 |
|---|---|
| 칩렛(chiplet)의 가능성과 필요한 기술들 (2) | 2024.11.16 |
| Mass Reflow-Molded Underfill (MR-MUF) 공정 (0) | 2024.11.14 |
| 열압착 비전도성 접착 필름(Thermally Conductive Non-Conductive Film, TC-NCF) 공정 (1) | 2024.11.13 |
| 삼성전자와 SK하이닉스의 HBM 적층 방식 비교 (1) | 2024.11.12 |

댓글